OSP & Soldering 도해
1. POST FLUX 도포하여 PCB표면(Cu)에 존재하는 OSP 피막과 화합하고 Reflow 온도에 의해 액체의 화합물 피막을 생성.
(POST FLUX 미도포 상태에서 납땜시 붙지 않음.)
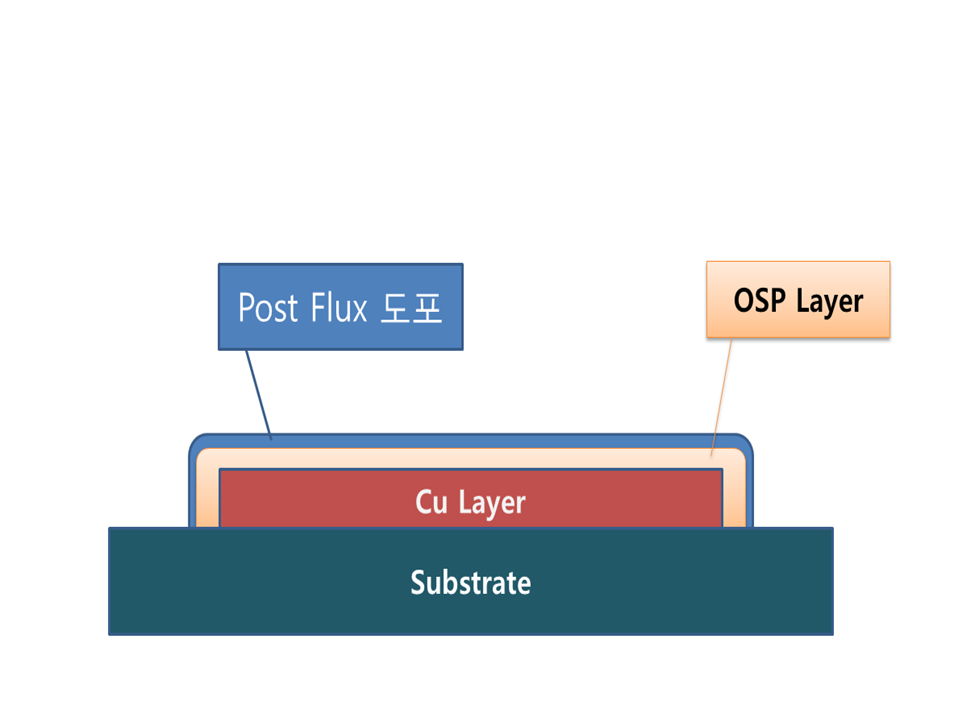
2. SOLDERING
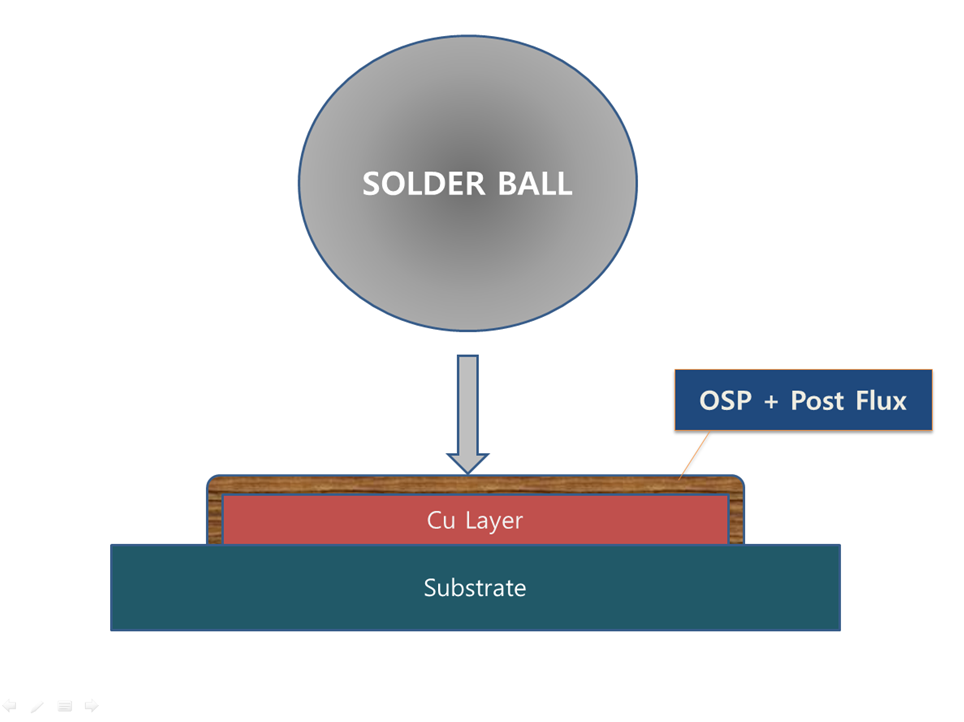
3.생성된 액체 화합물과 Post Flux 잔사는 Soldering 중에 액체상태 그대로 납땜 부분과 그 주변의 표면을 유동하면서 덮으며 표면을 공기 중의 산소가 침입하는 것을 순간적으로 차단.
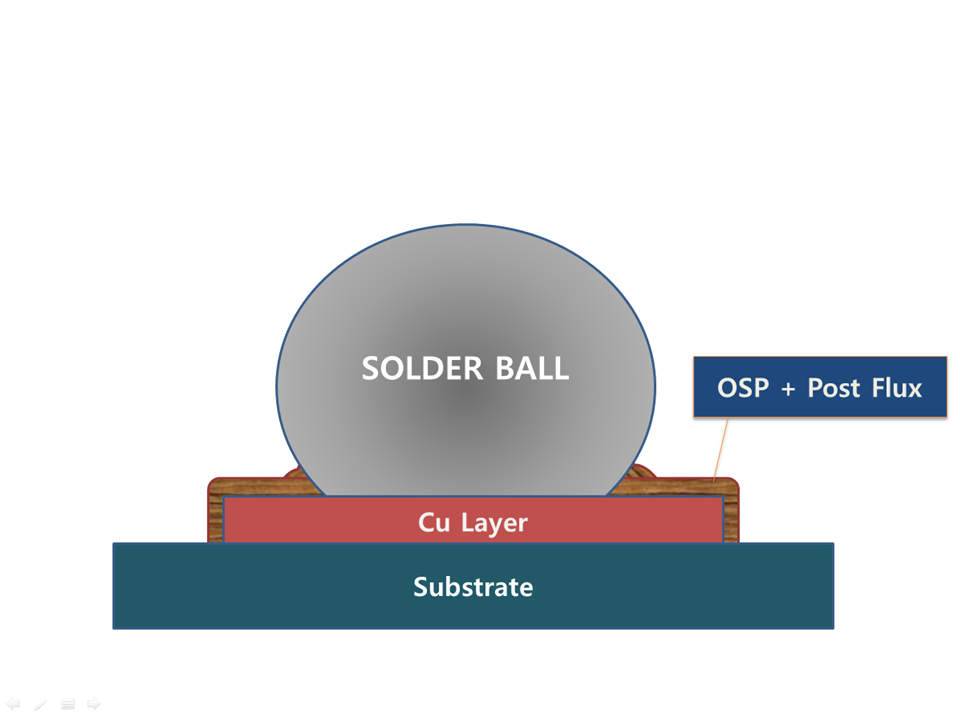
4.청정한 금속 원자의 표면을 갖는 PCB 표면(Cu)과 녹아 내린 Solder 합금이 액상의 Post Flux 화합물과 잔사가 유동하면서 산소의 침입을 막으면서 빠져 나가는 동시에 Cu와 Solder가 서로 접촉하여 그곳에 원자간 충돌이 실현되어 합금이 달성.